原文标题:HBM供应商扩容 英伟达有望集齐存储三巨头 供货时间表曝光
为了更妥善且健全的供应链管理,英伟达计划增加HBM供应商。之前英伟达的HBM由SK海力士独家供应,但如今三星与美光都将加入——换言之,三家存储龙头都将为英伟达供应HBM。
其中,TrendForce今日最新报告指出,新供应商三星的HBM3(24GB)预期将于今年12月在英伟达完成验证。
而HBM3e方面,美光已于今年7月底提供8hi(24GB)英伟达样品,SK海力士已于今年8月中提供8hi(24GB)样品,三星则于今年10月初提供8hi(24GB)样品;预计他们将在2024年第一季完成HBM3e产品验证。
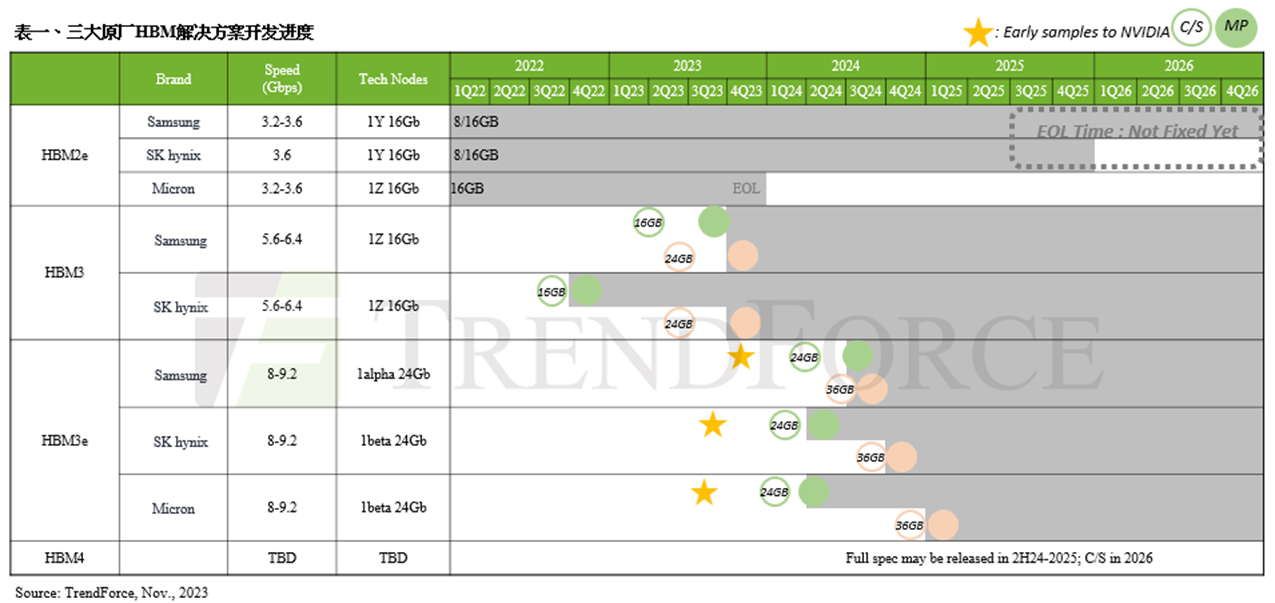
英伟达搭载HBM的是什么新品?TrendForce指出,英伟达2024年的产品组合分类将更为细致,除了之前的既有产品A100/A800以及H100/H800之外,还将推出使用6颗HBM3e的H200以及8颗HBM3e的B100,并同步整合自家基于Arm架构的 CPU与GPU,推出GH200及GB200。
至于另一AI芯片巨头AMD,其2024年出货主流为MI300系列,采用HBM3,下一代MI350将采用HBM3e,预计2024下半年开始进行HBM验证,TrendForce预计,预计2025年第一季才能看到较明显的产品放量。
至于下一代HBM新品HBM4,HBM4 12hi将于2026年推出,而16hi产品则预计于2027年问世。在HBM4中,最底层的Logic die(又名Base die)将首次采用采用12nm制程晶圆,该部分将由晶圆代工厂提供,使得单颗HBM产品需要晶圆代工厂与存储器厂合作。
值得注意的是,上周已有消息指出,SK海力士计划将HBM4通过3D堆叠直接集成在芯片上,发展方向已确定,具体商业模式正在推进。SK海力士也正与英伟达等多家半导体公司讨论这一新集成方式,英伟达与SK海力士或将共同设计芯片,并委托台积电生产。(详见《科创板日报》此前报道)
HBM正成为HPC军备竞赛的核心
毋庸置疑的是,无论产品进度如何,AI热潮实实在在地推升了HBM的需求。
方正证券11月14日报告指出,HBM正成为HPC军备竞赛的核心。算力需求井喷叠加产能受限,HBM价格高增,市场规模高速增长。
从成本端来看, HBM平均售价至少是DRAM三倍;而此前受ChatGPT的拉动同时受限产能不足,HBM价格一路上涨,与性能最高的DRAM相比,HBM3的价格上涨了五倍。
TrendForce认为,高端AI服务器GPU搭载HBM芯片已成主流。2022年全球HBM容量约1.8亿GB,2023年增长约60%达2.9亿GB,2024年将再增长30%。券商以HBM每GB售价20美元测算,2022年全球HBM市场规模约为36.3亿美元,预计至2026年市场规模将达127.4亿美元,对应CAGR约37%。
落实到产业链环节上,民生证券认为,HBM将拉动上游设备及材料用量需求提升。
(1)设备端:TSV和晶圆级封装需求增长。前道环节,HBM需要通过TSV来进行垂直方向连接,增加了TSV刻蚀设备需求;中段环节,HBM带来了更多的晶圆级封装设备需求;后道环节,HBM的多芯片堆叠带来diebond设备和测试设备需求增长。
(2)材料端:HBM的独特性主要体现在堆叠与互联上。对于制造材料:多层堆叠对于制造材料尤其是前驱体的用量成倍提升,制造材料核心厂商包括:雅克科技、神工股份等;对于封装材料:HBM将带动TSV和晶圆级封装需求增长,而且对封装高度、散热性能提出更高要求,封装材料核心厂商包括:联瑞新材、华海诚科、飞凯材料等。
方正正补充称,国内产业链有望在各品类半导体设备、材料受益:1)固晶机:新益昌;2)测试机、分选机等:长川科技;3)特种气体:华特气体;4)电子大宗气体:金宏气体、广钢气体;6)前驱体:雅克科技;7)电镀液:天承科技;8)环氧塑封料:华海诚科。
本文由艺馨股指期货网整理编辑发布,地址:http://www.kymths.com/peizichaogu/2023/1128/3800.html,转载请注明出处!


